贺利氏电子与日本半田达成烧结银专利交易协议 电子封装技术迎来关键突破
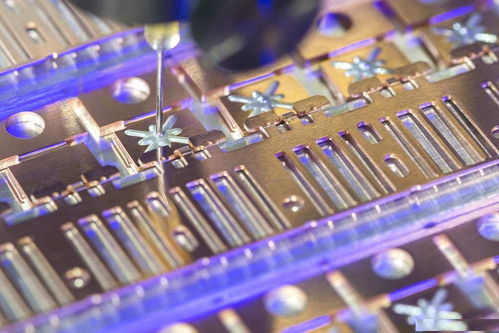
全球领先的电子材料供应商贺利氏电子与日本知名电子材料企业半田株式会社正式宣布,双方已就烧结银技术相关专利达成一项重要交易协议。这一合作不仅标志着两家行业巨头在先进封装材料领域的深度协同,更预示着电子制造业,特别是功率半导体和高温电子封装技术,将迎来新一轮的创新与效率提升。
烧结银作为一种高性能的导电粘结材料,在高温、高功率密度应用场景中展现出不可替代的优势。与传统焊料相比,它具有更高的导热性、导电性以及卓越的可靠性,能有效应对电动汽车、可再生能源、工业电机驱动等严苛环境下的散热与电气连接挑战。此次贺利氏电子与日本半田的专利交易,核心在于整合双方在材料配方、工艺优化及量产应用方面的独家技术与知识产权,旨在加速烧结银解决方案的标准化与普及化进程。
对于贺利氏电子而言,此次协议进一步巩固了其在先进电子封装材料市场的领导地位。公司凭借其深厚的冶金与材料科学积淀,已开发出多款适用于不同封装形式的烧结银产品。通过吸纳日本半田在精细化工与涂覆工艺方面的专利技术,贺利氏有望优化现有产品线,提升材料在微电子互联中的精度与一致性,从而满足5G通信、人工智能芯片等前沿领域对封装可靠性的极致要求。
另一方面,日本半田通过此次交易,不仅实现了其研发成果的商业化价值最大化,也得以借助贺利氏的全球销售网络与应用技术支持体系,将其技术更快速地推向国际市场。这种“技术-市场”的强强联合模式,有助于缩短创新技术从实验室到量产的时间周期,降低下游制造商的导入门槛。
从行业影响角度看,此次合作有望缓解当前高端电子封装领域对传统铅基焊料或导电胶的依赖,推动产业向更环保、高性能的解决方案转型。特别是在全球碳中和目标及电动汽车爆发式增长的背景下,烧结银技术能够显著提升功率模块的能效与寿命,对于电力电子设备的轻量化、小型化发展具有战略意义。
随着物联网、自动驾驶等技术的不断演进,电子封装将面临更高的集成度与更复杂的散热需求。贺利氏电子与日本半田的此次专利交易,不仅是两家企业间的商业行为,更可被视为电子材料行业协同创新、共塑技术标准的重要里程碑。它预示着产业链上下游将通过更开放的知识产权合作,共同攻克技术瓶颈,驱动整个电子产业向更高可靠性、更高性能的新时代迈进。









